Spectroscopic ellipsometer
Spectroscopic ellipsometer Jobin-Yvon
(UVISEL-NIR)
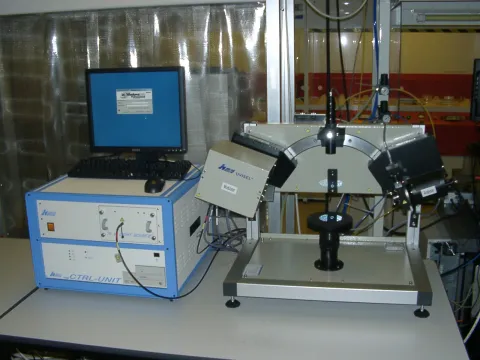
Contact :
Laurent ROBERT
TEMIS Sciences Building – Office N1-21
03 81 66 66 47 (Office)
03 63 08 21 04 (Characterization Area)
laurent.robert [at] femto-st.fr (laurent[dot]robert[at]femto-st[dot]fr
)
Location :
TEMIS cleanroom
Characterization Area
Principle :
Ellipsometry is a non-destructive method for measuring the index and the thickness of thin dielectric layers. This technique enables to obtain the optical response of a material by studying the polarization ellipse modification of an incident beam during the beam reflection on the sample surface.
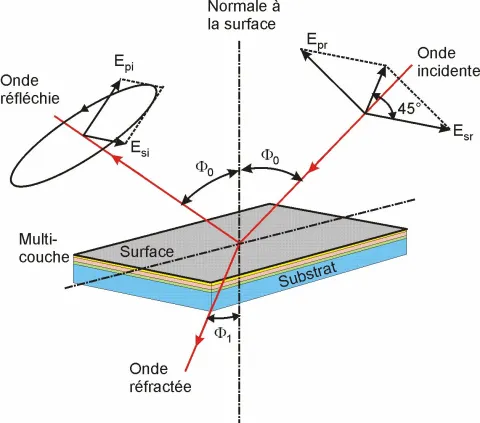
Technical characteristics :
- Spectral measurement range : 260 < ![]() < 2100 nm
< 2100 nm
- Spot size (microspot system) : 50, 100 µm and 1 mm
- Xe source : 75 W
- Analysis system fitted with a thermally stabilized photoelastic
modulator set on an automatic rotary stage (modulation frequency : 50
kHz)
- HR460 high resolution double output monochromator with near-infrared extension (typical resolution: 0.1 nm)
- 2 detectors: a photomultiplicator and an InGaAs detector
- Sample holder : 6 inch diameter with an adjustment system (in rotation...)
- Manual height adjustment, maximum thickness : 20 mm;
- Thickness and index extraction softwares: : DeltaPsi2 (version 2.4.3)
- Possibility of transmission measurements ( 0 = 90°)
0 = 90°)
Measurable materials :
- Dielectric tranparent materials : SiO2, TiO2, Ta2O5, Si3N4, SiOxNy , polymers …
- Semi-conductors : Si, AsGa, …
- Metals









