You are here
ICP-PECVD SENTECH
SI 500 D ICP Deposition System
Deposition of silicon nitride, silicon oxynitride and silicon oxide
at low temperature by plasma deposition system

Contact :
Cyril MILLON
Bâtiment TEMIS Sciences – Bureau N3-12
03 63 08 63 02 (Bureau)
03 63 08 23 77 (Salle Dépôt)
cyril.millon@femto-st.fr
Localization :
Cleanroom TEMIS
Overview :
High-density
plasma technology is becoming increasingly attractive for the
deposition of dielectric films such as silicon nitride (SiNx), silicon
dioxide (SiOx), silicon oxynitride (SiONx) and hydrogenated amorphous
silicon (a-Si:H). In particular, inductively-coupled plasma chemical
vapor deposition (ICPECVD) offers a great advantage for low temperature
processing over plasma-enhanced chemical vapor deposition (PECVD) for a
range of devices including compound semiconductors (InP, GaAs ...). The
material properties of these films have been investigated as a function
of ICP source power, RF chuck power, chamber pressure, gas chemistry,
and temperature.
The ICPECVD films will be compared to PECVD films
in terms of roughness, homogeneity, refractive index, density and other
film characteristics. Compare to the traditional high temperature
technology, the fabrication of MOEMS-MEMS/ NEMS and semiconductors at
lower temperature have many advantages (i.e. the co-integration).
The
SI 500 D plasma enhanced deposition tool is configured to deposit SiOx,
SiNx, SiONx, and a-Si:H films in a temperature range from room
temperature up to 350 °C with lower hydrogen content. The large range of
thin dielectric properties also allows addressing optical applications.
A brief insight into the possibilities of this kind of gases mixtures,
on thin layers properties with different stoichiometries, has been
investigated. A database is available at FEMTO-ST for the applications
in Optoelectronics, Microelectronics and Microsystems
DESCRIPTION and SPECIFICATION :
- Specification of gases process : SiH4, NH3, O2, Ar
- Vaccuum system : Pressure <10-6 mbar
- ICP source :
- Pressure: 1 Pa ...20 Pa
- Power: 100 ... 1200 W
- Plasma density: up to 5*1011 cm-3
- RF power supply : @13.56 MHz, 1200 W
Achieved results :
Lift-Off @ 80°C :
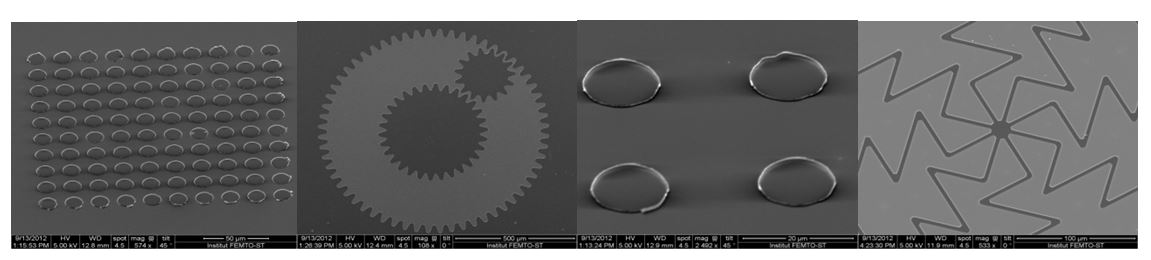
SiO2 with conformal coverage :
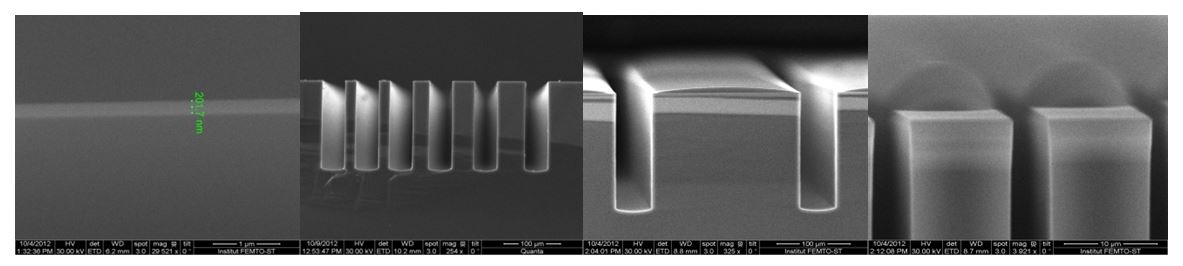
State of the Oxyde : SiO, Si2O, Si2O3, Si02
State of the Nitride : SiN, Si3N, Si3N2, Si3N4
State of the Silicon Oxyde nitride : Si2N0, Si2N02, Si2N2O, SiNO, Si2N03,Si2N3O










